「測ること」は半導体製造の真髄?
TELが活用する測定技術
Technology
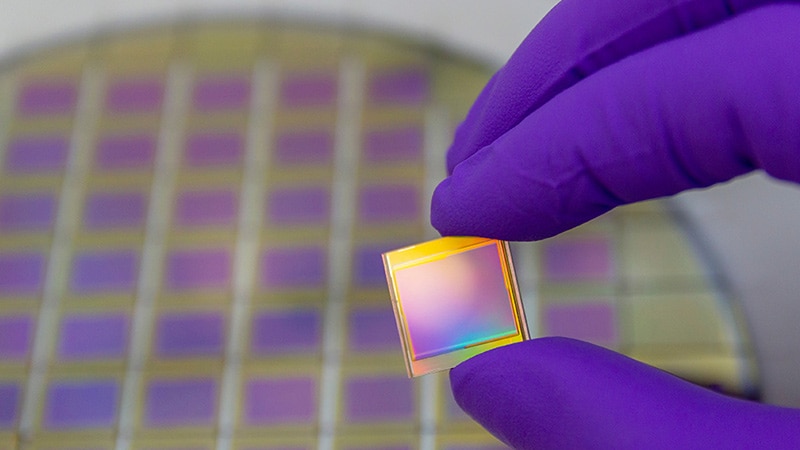
半導体は、スマートフォンやパソコン、自動車などの核となる超高精度な部品だ。その製造においては、ナノメートル単位のズレや性能の誤差も許されない。だからこそ、さまざまな数値を精度高く“測る”技術が必要になる。
本記事では、半導体製造技術における“測定”の重要性を紹介。“測る”の世界を案内していく。
半導体における「測定」の役割
半導体の製造工程には、多数のプロセスが積み重なっている。設計どおりの形状や寸法が保たれているか確認するのに欠かせないのが、さまざまな「測定」だ。
例えばSSDやUSBメモリ、SDカードなどのストレージデバイスで広く使われているNAND型フラッシュメモリ(512GB)では、おおよそ1000工程のうち、400回の検査や計測がおこなわれる。
そこで意図したとおりの数値が出るということは、性能の確からしさが証明できるということ。測定は品質管理だけでなく、工程の改善や歩留まり(良品率)の向上にもつながっているのだ。
そのため東京エレクトロン(以下:TEL)は、測定技術の自社開発にも取り組んできた。例えば、真空中やプラズマ中、1000℃を超える高温、マイナス100~150℃(あるいはそれ以下)の低温といった過酷な環境下で開発を進めるためには、正確な温度測定装置が必要である。温度を正確に測れる技術が世の中になければ、自分たちで物差しをつくるしかない。そうした技術開発も含めて、TELは測定と向き合ってきた。
TELが活用する測定技術
ここからは、TELが実際に現場で活用している測定技術を紹介していく。
工程の前後で薄膜の厚みを測る「光学式膜厚測定」
半導体製造装置は、薄い膜をいくつも重ねながら微細な回路を形成していく。膜を重ねたり、加工したりする工程において、設計図どおりの厚みになっているかを確認するのが「膜厚測定」だ。
半導体の膜の厚さは、電子部品の動作や電気の伝わり方に直結するため、厚すぎても薄すぎても不良や性能低下につながる。膜厚測定は、多くの工程の前後で頻繁に使われる、半導体製造の基本的な測定技術といえるだろう。
どうやって測るの?
半導体の現場では、光学式の膜厚測定がよく使われている。「測りたい薄膜に光を当て、返ってきた色や強さのパターン(干渉波形)から膜の厚さを逆算する」方法だ。
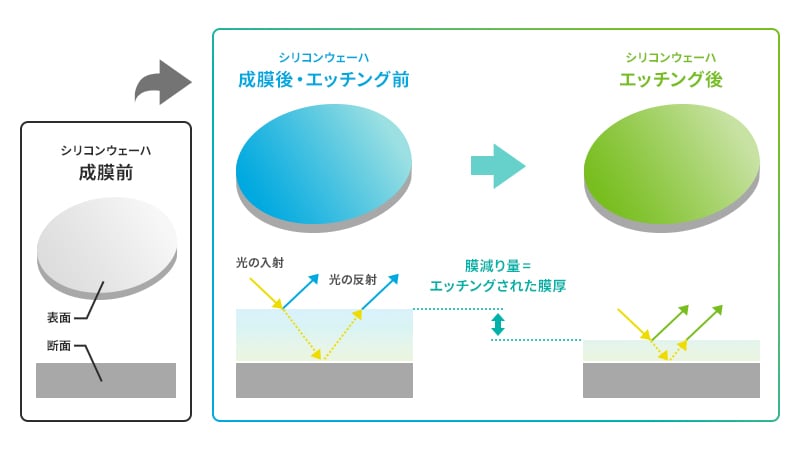
例えば、シャボン玉は周りの光を反射して、虹色にきらきらと光る。シャボン玉の膜の厚みが部分ごとに違っていて、干渉波形に差があるために、場所によって違う色に見えるのだ。同じように半導体製造装置の薄膜も、場所によって色や光り方が異なるため、そのパターンから厚みを逆算できる。


膜厚の違い(不均一さ)を色の分布や3Dマップで“見える化”する(画像提供:KLA)
膜にはさまざまな種類があり、光が内部まで通る材質であれば、この光学式の膜厚測定で対応できる。光が通らない、または乱反射してしまう膜は光学式で測るのが難しいため、レーザーや接触式段差計といった別の技術と組み合わせて厚さを測定する。
測定事例の紹介
実際に、膜が付いたウェーハをエッチング加工した事例がこれだ。膜厚測定器でウェーハ全体の300ヶ所を測定した結果を、3次元マッピングで表現している。ウェーハには薄膜形成装置により、シリコン窒化膜が250nm成膜されている。膜の厚い部分と薄い部分で14.5nmの高低差がある。(画像左)。
プラズマエッチング装置によってこの膜を必要な厚さまで削ると、全体の厚さは140nmに減少し、膜の厚い部分と薄い部分の差が13.5nmとなっている。また、凹型だった膜厚分布が変化する(画像中)。これは中心部分と外周部分のエッチング速度が異なるためで、エッチングの加工条件を変更することで分布を制御できる(画像右)。このようにして、中心部と外周部の厚みやばらつきを調整していく。
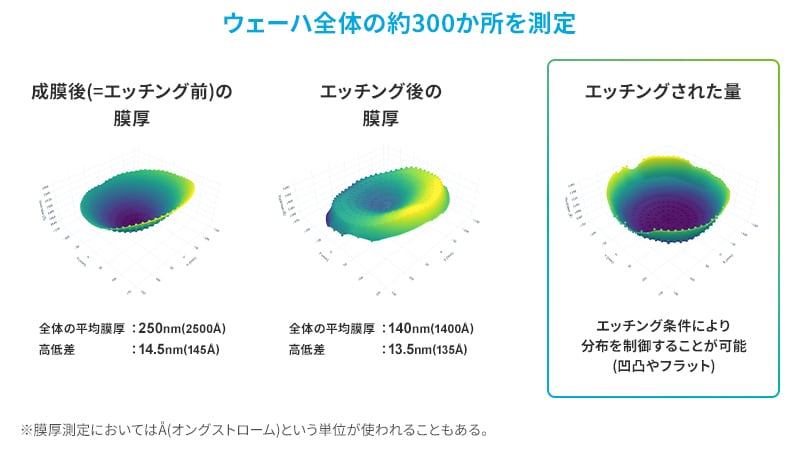
目に見えない表面の凸凹や穴の深さを測る「走査型電子顕微鏡(SEM)」
SEMは、ウェーハの表面にある超微細な凸凹を測る技術だ。光学顕微鏡では見えない、ナノメートル単位の微細構造まで観察できるのが特徴。回路パターンの幅や欠陥、穴の深さや断面の形状など、小さすぎて見えない「表面の状態」や「立体的な寸法」を測定してくれる。
どうやって測るの?
まず、特別な道具を用いてウェーハを割り、3~4mm程度の試料片を作成。試料片をホルダーにセットし、SEMで電子ビームを当てて、表面の凸凹を可視化する。電子ビームの返ってくる信号が多い部分は白く、少ない部分は黒く映る。
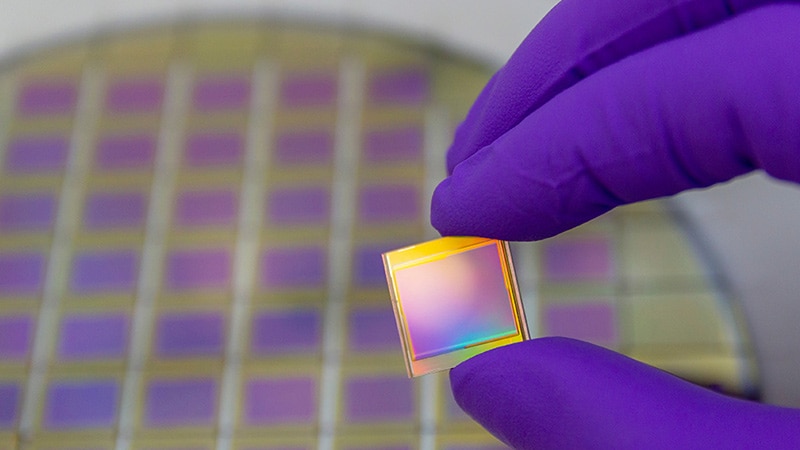
1. ウェーハから、測定に適した試料を作製する(劈開する)のはとても難しい、職人の技

2. 約3mmの試料片をホルダーにセットする

3. ホルダーをSEMに取り付けて、測定開始
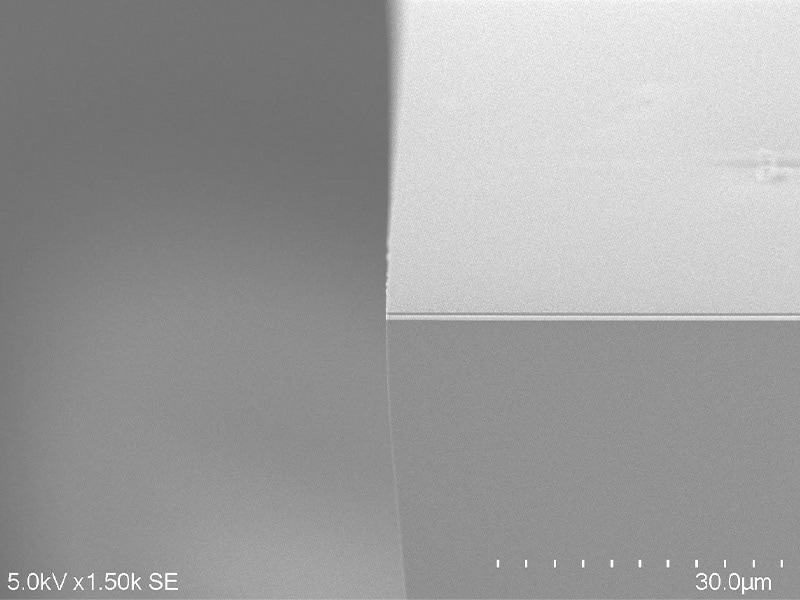
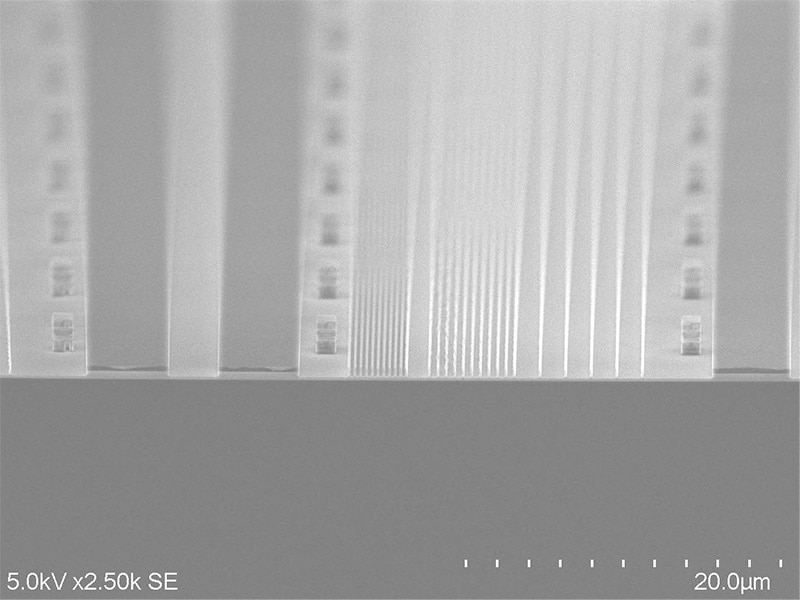
4. 低倍率で観察場所を探していく(写真左は試料片の角部分)
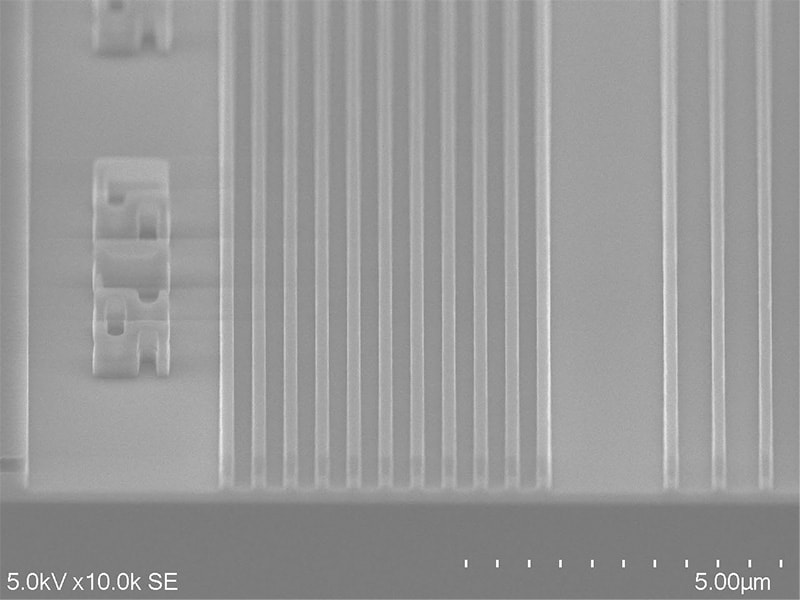
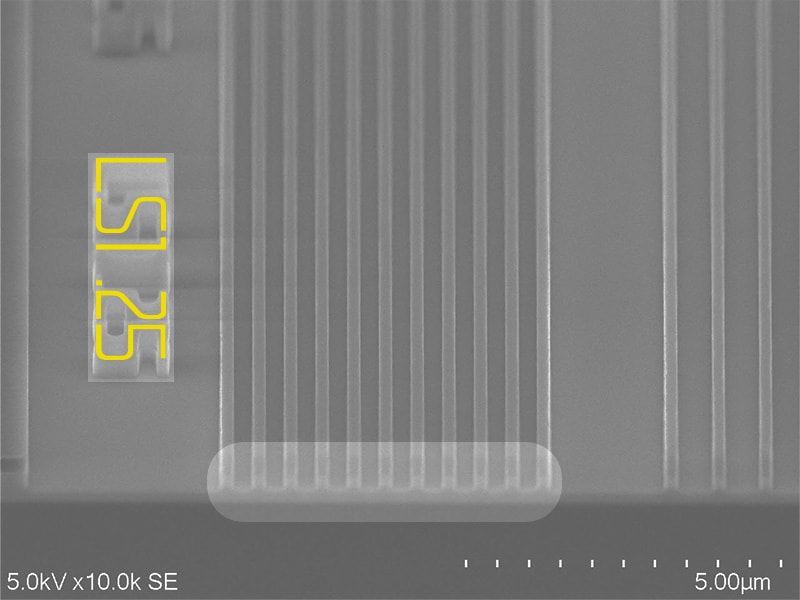
5. 観察するポイント(”LS 1.25” LineとSpaceの間隔が1.25倍のパターン)
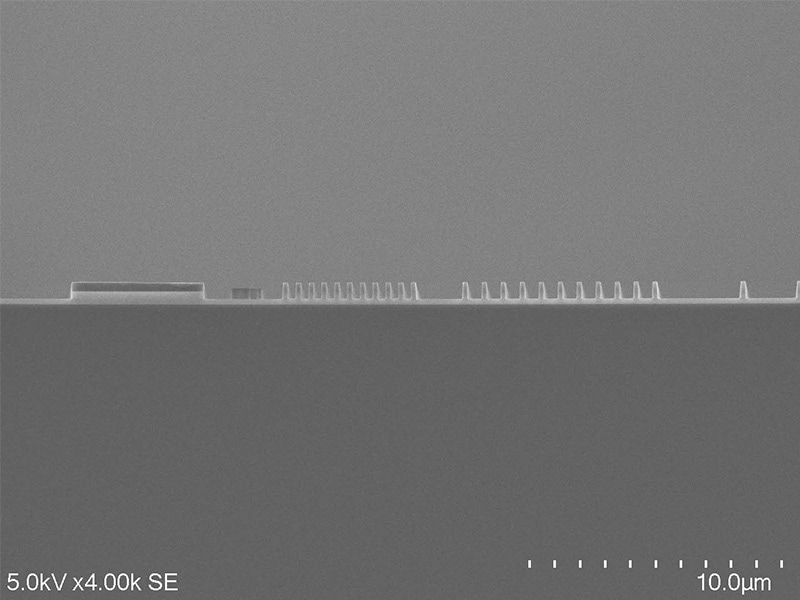
6. 断面を観察するため、試料の角度を水平にする
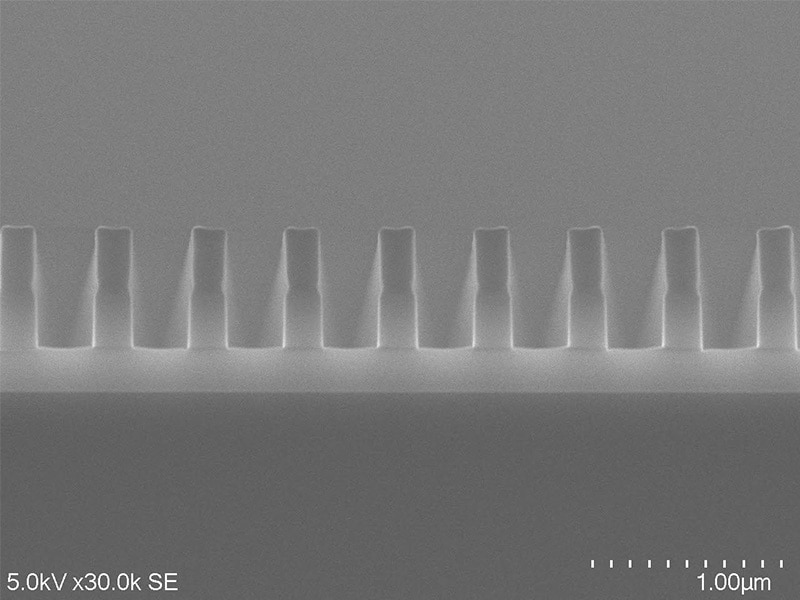
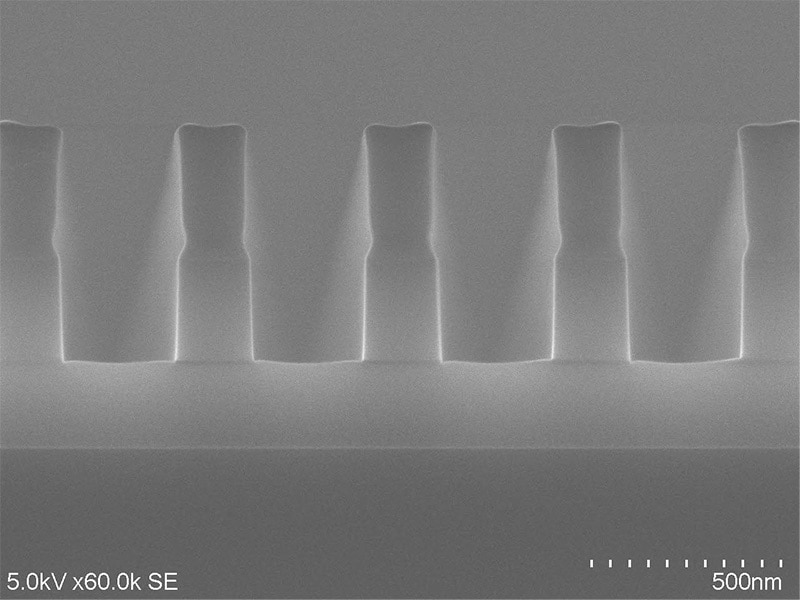
7. 倍率を3万倍→6万倍と徐々に拡大して“撮影”
写真1-7の出典:TEL
「測る」とは正しい技術を選び、形や機能を数値化していく作業
今回は膜厚測定とSEMを取り上げたが、半導体製造フローにおいては、他にもさまざまな測定技術がある。代表的なのはフォトリソグラフィ寸法測定、電気的特性測定、不純物/元素分析、結晶性測定、トポグラフィ測定などで、それぞれに測定の原理や使い道が違う。
半導体の測定においては、そうしたさまざまな技術から、何を選ぶかが非常に大切だ。光を通さない膜に光学式測定器を使ったり、ミクロまでしかない物差しでナノを測ろうとしたりしても、意味がない。技術を正しく理解して、適切な方法を選ばなければいけないのだ。
測ることは単なる状況の確認作業ではなく、製造プロセス全体を支える“重要な制御手段”。正確な測定を経て初めて、高性能で信頼性の高い半導体製品が世に出ていくのである。



