洗浄 CELLESTA™シリーズ
業界最高レベルの、「乾燥性能」「生産性」「安定性」を実現した枚葉洗浄装置

CELLESTA™シリーズは、最新鋭の洗浄プロセス研究成果を搭載した300mmウェーハ対応枚葉洗浄装置です。高スループット、省フットプリントを実現しながら、次世代洗浄乾燥技術への拡張性を実現しました。高い信頼性と生産性で世界中のお客さまから認められており、最先端の洗浄装置として、ウェーハ表面処理へのさまざまなニーズに対応すべく進化を続けています。
CELLESTA™ -i MDは、10nmノード以細の最新洗浄プロセスに対応した300mmウェーハプロセス用の枚葉洗浄装置です。すでに多くのお客さまから支持をいただいているCELLESTA™ -iの基本コンセプトを発展させ、最先端の微細化パターンへのダメージレス洗浄を可能とし、パーティクル除去性能を大幅に向上させています。さらにウェーハ洗浄後のチャンバー内雰囲気制御技術と独自のIPA吐出技術を新たに採用し、ごく微細なパターンにおいてもパターン倒壊を抑制した乾燥性能を実現しました。同時に薬液のリサイクル機能を向上させ、さらなるランニングコストの低減と生産性向上に貢献しています。CELLESTA™ -i MDのユニークな装置コンセプトは、Cuなどのメタル露出時洗浄プロセスへも適用可能な拡張性を実現しました。今後、より複雑化を増す半導体製造におけるさまざまな薬液を用いたプロセスニーズへの幅広い対応を可能とし、最先端の枚葉洗浄環境を強力にサポートします。
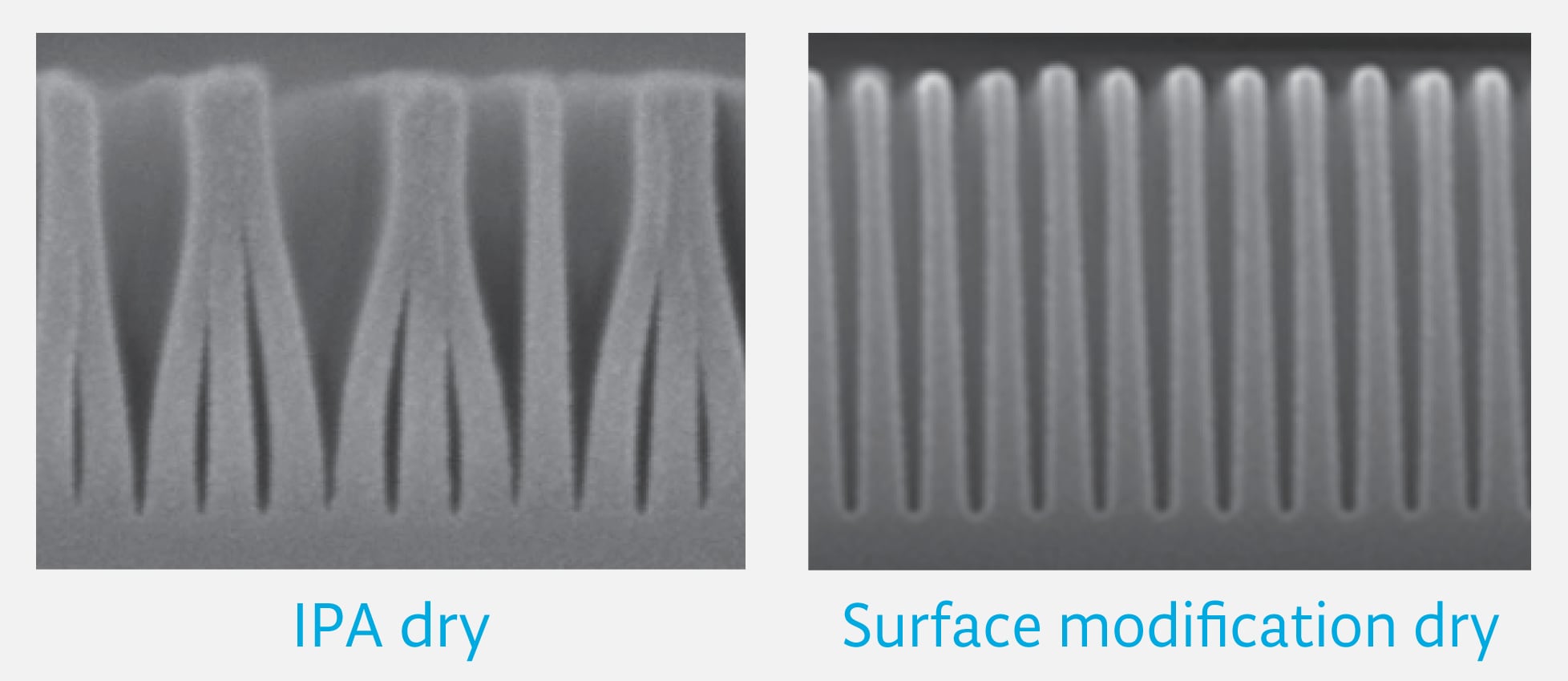
次世代向けパターニング倒壊抑制技術
CELLESTA™ -i は、生産性を向上させると同時に装置のフットプリントを抑えることで、従来装置に比べてクリーンルーム占有面積の大幅な低減を実現した300mmウェーハ対応枚葉洗浄装置です。最大20 ユニットの洗浄チャンバー搭載が可能で、1m2当たりにおける生産性は世界最高水準を誇ります。また、低CoO化を実現するための薬液リサイクル技術や、ウェーハ上のパーティクルを除去するための物理洗浄装置も搭載しています。さらに、ウェーハ外周部の洗浄技術に特化した最先端のベベル洗浄ユニットや省薬液での裏面洗浄ユニットを搭載可能で、非常に高い拡張性をもちます。半導体製造プロセスにおけるさまざまなニーズに合わせて、独自の洗浄プロセスシーケンスとコントロール性能を提供します。
CELLESTA™ MS2は、2流体スプレーおよびブラシによる物理洗浄機能を備えた洗浄装置です。本装置は、両面同時処理を実現したことで、従来製品と比較してさらに高い生産性を実現しています。両面処理時の単位面積当たりの生産性は従来装置より1.5倍以上(当社比)となりました。同時に、従来は洗浄時に非洗浄面の保護のために使用していた純水やガスを使用しないことで、プロセス時の用力使用量の削減にも貢献します。また、TEL独自のウェーハ保持技術により、これまで課題であったウェーハ最外周部およびベベル部分までの洗浄を可能とし、最先端の半導体製造で求められるパーティクル制御性を兼ね備えています。今後、最先端半導体プロセスにおけるお客様のニーズに対し、物理洗浄技術により高い生産性・歩留まり向上に貢献します。
シリーズの比較
 |
 |
 |
|
| Wafer size (mm) |
300 | 300 | 300 |
| Availability | New | New | New |
| Throughput (wph) |
650 | 650 | 900 |
| Process | Pre/Post clean, Wet etch | Pre/Post clean, Wet etch | Physical force Clean |
| Substrates | Si | Si | Si |
| Dry method | New IPA dry /SMD | Hot IPA dry | Spin Dry |
CELLESTAは、東京エレクトロングループの日本およびその他の国における登録商標または商標です。



