成膜 Triase+™シリーズ
幅広い成膜アプリケーションに対応し、先端デバイスの技術課題に対して最適なソリューションを提案

TELの枚葉成膜装置は、最新300mmプラットフォームTriase+™ を中心に、バラエティに富んだプロセスモジュールをクラスター化させることで高い付加価値を提供しています。そのなかの代表的なプロセスモジュールであるTi、TiN、Wのメタル成膜装置は、プラグ形成工程や電極工程などに長年ご採用いただき高い評価を得ています。SPAシリーズはそのユニークなハードウェアを活用し、低温プラズマ処理装置として半導体製造前工程プロセスニーズに対応、実績を伸ばしています。
Triase+™ EX-II™ TiN(TiN:窒化チタン)は、TiCl4を使用した高ステップカバレッジTiNの成膜が可能な300mmウェーハ対応最先端高速枚葉ASFD*1装置です。チャンバー反応空間の最適化と新たなガス導入機構を実装し、最先端デバイスニーズに対応するテクノロジーと高い生産性の両立を実現しました。
半導体デバイスの微細化、構造の3次元化に伴い、高アスペクト比形状への成膜はますます難しさを増します。Triase+™ EX-II™ TiN Plusは、複雑な構造に対しても均一なTiN成膜を実現するため、従来モデルからチャンバー反応空間とガス導入機構を一新し、面内均一性、ステップカバレッジ、生産性を大きく向上させました。さらに低抵抗で高純度なTiN成膜を実現すべく、高温プロセスに特化したハードウェアを備えた装置Triase+™ EX-II™ TiN Plus HTを開発し、MIMキャパシタ*2の電極形成向けにリーク電流低減プロセスを提供するTriase+™ EX-II™ TiON(TiON:酸窒化チタン)を新たにラインアップに加えました。Triase+™ EX-II™ TiNシリーズは、コンタクトバリア、キャパシタ電極、ワードラインバリア、メタルゲートなどさまざまなメタル成膜アプリケーションに対応します。それぞれの製品には最大4チャンバーのプロセスモジュールが搭載可能で、チャンバー毎に最適化されたクリーニング技術を採用し、高い生産性と低CoCを実現しています。
*1 ASFD:Advanced Sequential Flow Deposition ナノスケールで低温かつ緻密な膜を成膜できる手法
*2 MIMキャパシタ:Metal(金属)-Insulator(絶縁膜)-Metal(金属) 絶縁膜を金属で挟み込んだキャパシタ構造
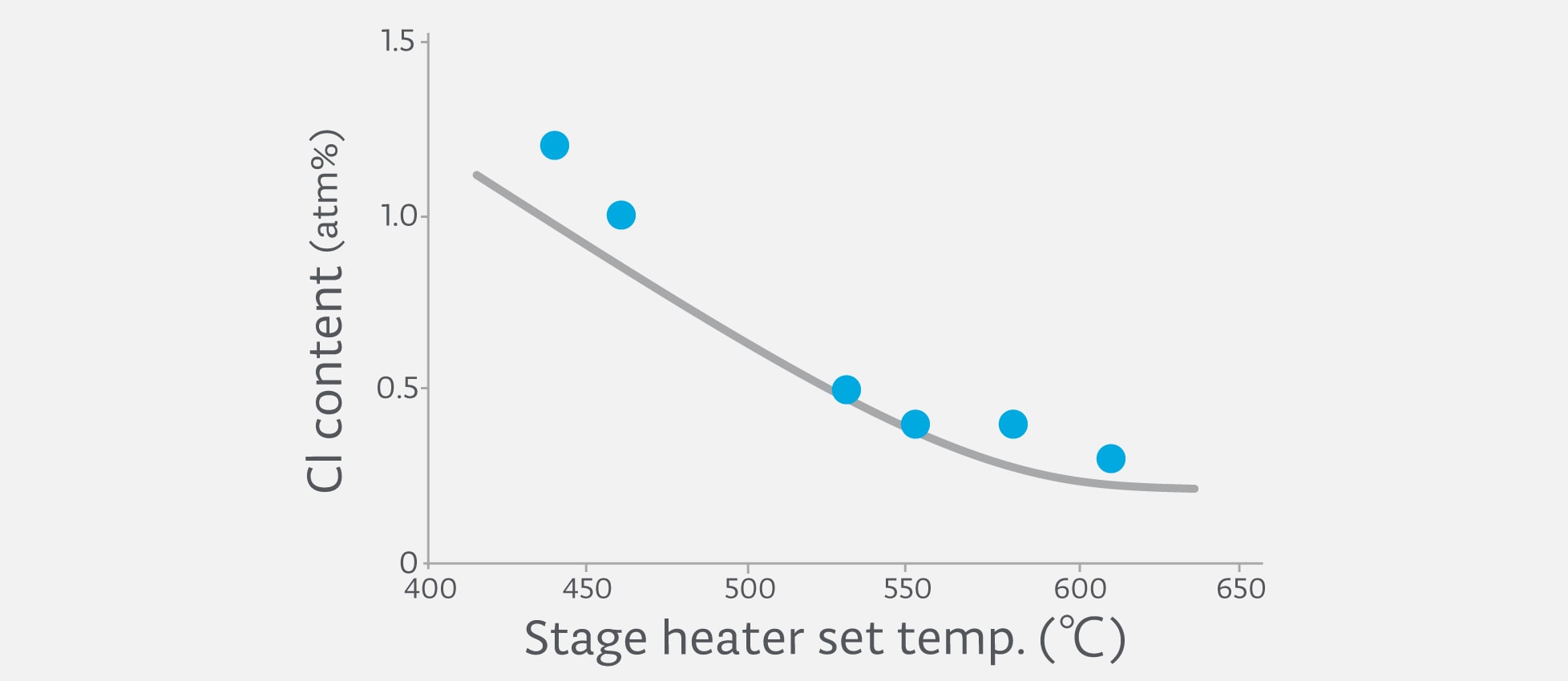
TiN膜Cl含有量
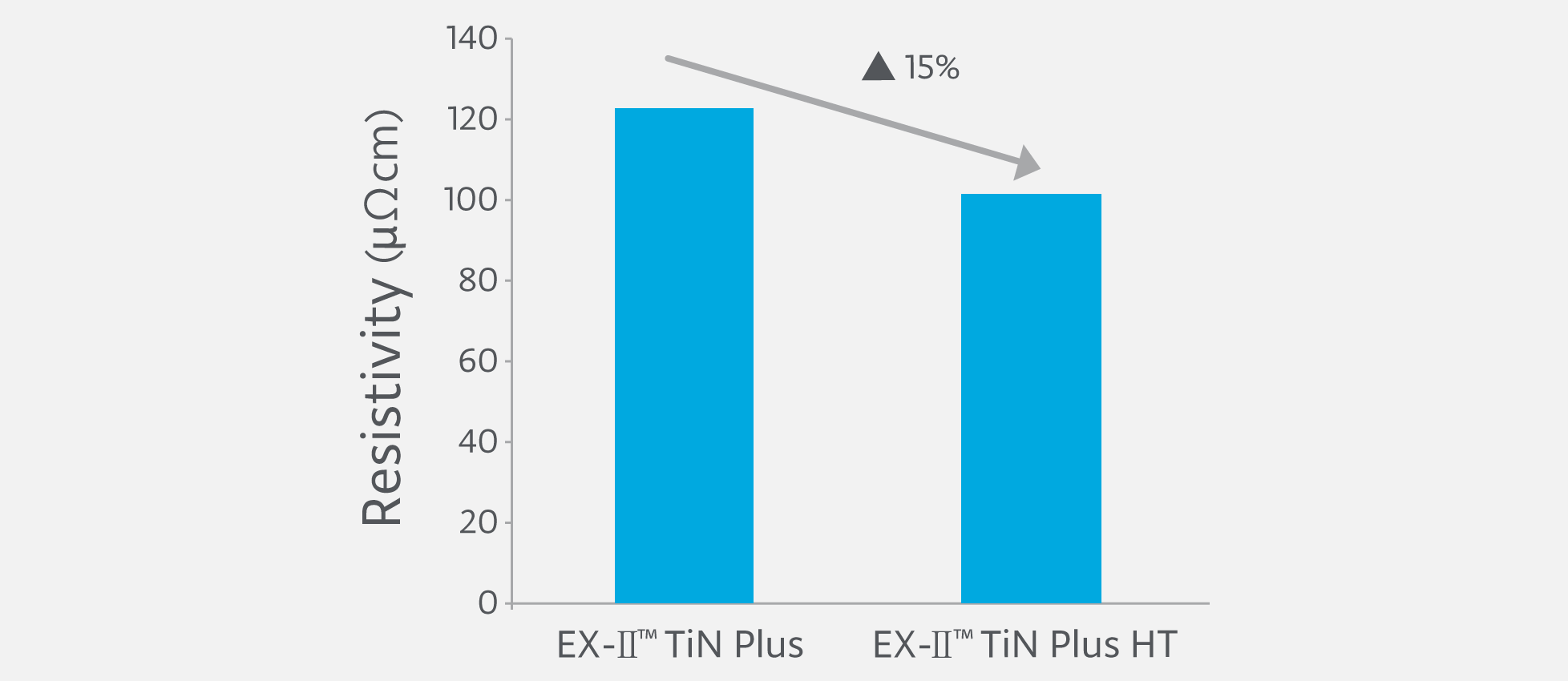
TiN膜低抵抗化
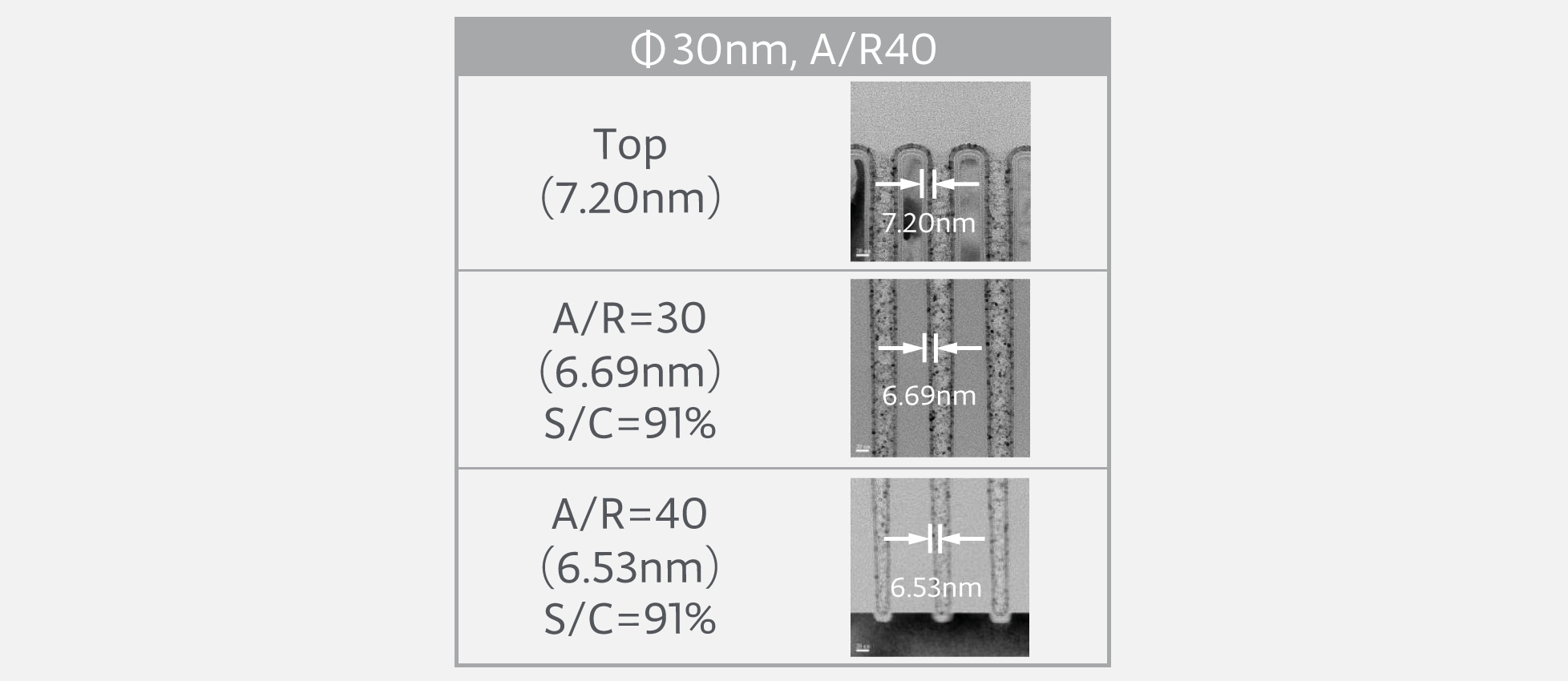
EX-Ⅱ™ TiN Plus HTカバレッジ
Triase+™ Ti/TiN(TiN:窒化チタン)は、TiCl4を使用した高ステップカバレッジのTi、TiN成膜を実現する300mmウェーハ対応枚葉CVD装置です。登場以来、これまで世界中の半導体量産工場において優れた量産実績と高い信頼性を誇り、さまざまなデバイスのコンタクト工程における低抵抗化と接合リーク低減の両立を実現しています。より微細で高アスペクト化が求められる工程には、ALDの高ステップカバレッジとCVDの高生産性を両立するSFD™を採用したTriase+™ SFD TiNが対応します。さらに、浅い接合やニッケルシリサイド層を有する次世代デバイスなどの多様化するニーズに応えるべく、Triase+™ HP Tiは最適なシャワーヘッド表面処理技術やTi成膜時におけるTiSi同時形成プロセス技術の導入など多くの付加機能を盛り込み、これまで課題とされてきたプロセス温度領域の拡張および微細化に向けてのパーティクル性能向上、生産性の向上を実現しました。また、次世代デバイスに向けさらなる高ステップカバレッジを実現したTriase+™ HP Ti Plusを新たに製品ラインアップに加えています。それぞれの製品には最大4チャンバーのプロセスモジュールが搭載可能で、チャンバー毎に最適化されたクリーニング技術を採用し、高い生産性と低CoCを実現しています。
Triase+™ Wは、WF6を使用した高ステップカバレッジのW成膜を実現する300mmウェーハ対応枚葉CVD装置です。ウェーハの高速昇降温が可能なランプ加熱技術、プラズマレス・チャンバークリーニング技術を採用しており、高い生産性と低CoCを実現します。SFD™による核付け層形成と、通常のCVDによるバルク膜形成を同一モジュール内でおこない、微細なホール形状においても高いステップカバレッジを実現します。また、さらなる微細化ニーズに対応するための、低抵抗膜の成膜プロセスを可能としました。コンタクトプラグ形成、ビアフィルなどの各種アプリケーションを提供します。
Triase+™ SPAiは、優れた生産実績と高い信頼性を誇るTriase+™ SPAシリーズの次世代バージョンとして、市場ニーズに応えるべく高生産性、環境負荷低減に注力して開発された装置です。Triase+™ SPAシリーズでは、TELが長年培ってきたSPA (Slot Plane Antenna)プラズマ生成技術による高密度、低電子温度のプラズマを利用した、低温かつダメージの少ないプラズマ処理技術を特徴としています。Triase+™ SPAiはこのユニークな特徴を継承しながら装置スループット向上をさせ、高生産性の実現と、低消費電力化によるCO2排出量削減、装置フットプリントの削減を可能としました。また、バイアス機能を備えることにより良好な膜質と高カバレッジ特性を両立させ、ゲート窒化、ゲート修復酸化、STIライナー酸化、High-k窒化などのクリティカルな各種前工程プロセスに対応します。
シリーズの比較
 |
 |
 |
 |
|
| Wafer size (mm) |
300 | 300 | 300 | 300 |
| Availability | Certified used | Certified used | Certified used | Certified used |
| Application | Capacitor electrode, Word line barrier, Metal gate |
Contact, Capacitor electrode |
Contact plug, Via Fill |
Gate nitridation, Gate recovery oxidation, STI liner oxidation, High-k nitridation |
| Process | ASFD TiN, TiON | CVD Ti/TiN | W | Oxidation, Nitridation |
| Substrates | Si | Si | Si | Si |
| Additional features | High step coverage, Good TiN film property, High speed deposition, Cycle time, ClF3 cleaning |
High step coverage, Simultaneous TiSi, Formation during Ti deposition, ClF3 cleaning |
High productivity, ClF3 cleanining |
Low tempreture and damageless plasma process, High density and low electron tempreture plasma |
Trias、Triase+、EX-IIおよびSFDは、東京エレクトロングループの日本およびその他の国における登録商標または商標です。




